�赲�㻯ѧ��е�⣨CMP�����������ʵ������
����һ�����ڼ��ɵ�·���ͭ�����赲��
������ɢ�赲��ɷ�Ϊ�����赲��ͽ����赲�����֣����������ǶԽ�����ɢ�赲�����˴����о�������������ѡ���ϰ���Ta��W��Ti�Լ����ǵĵ�����TiN��WN��TaN�ȣ�����һЩ������ TiW��TaC�ȣ����������������䡢CVD�ȡ�
�������ڳ��������赲��ʱ���ò�����Ƿ�ѡ���Ե���ȫ������SiO2�ϵģ���˻����뽫��֮��Ľ����赲����ȥ������õķ�������CMP����ͭ���ʱ����ȥ�������ԣ������赲�����һ����Ҫ���������ڱ�CMPȥ���������ȶ��Ժ���ͭ�ĸ�������������������Ta�ƺ��DZȽ�����Ľ����赲�㡣Ȼ��������Ta��һ��Ӳ���������ױ�CMPȥ����������Ta��CMPҲ��Ϊȫ��ƽ�滯�Ĺؼ�����֮һ��
���������赲��CMP�Ļ���
����CMP�����Ƕ��ѧ�ͻ�е���õ��ۺϹ��̣���ѹ������ת���������Լ��ͷ�Ӧ����ӽӽ�����ת�Ĺ��������Ӷ������ӣ�����֮���ײ��Ҳ��֮���࣬�ﵽ��ܵ������������Ӵ���CMP�У�����������Ҫ�Ķ���ѧ�����Ǿ��ǻ�ѧ����ѧ���̺�����ɢ���̣��������߿������ʡ�Ϊ�˴ﵽ���õ���Ч������֤�����ƽ���������ˡ��߹�ࡢ����Ⱦ��������������м����������ݵĹ��̡�
������������Ӳ�Ⱥܴ���ȥ����ͨ������Һ��Ta��TaN��������Ѷȴ�ȥ���ʵͣ���ͭȥ�����࣬���ֵ��Ϳӣ����˲����������Դﵽȫ��ƽ�滯�������⽬����ɶ��豸��ʴ���Ի�����Ⱦ�����⡣���Ҽ���CMP������ʹ��ͬһ����Һ��ͭ��CMP���ʺ�Ta��CMP�������ܴ�������������ɵ��οӣ�ͼ1����
����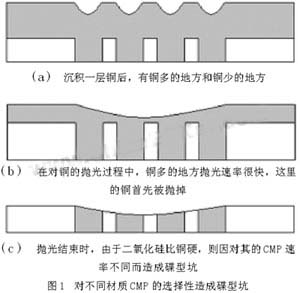
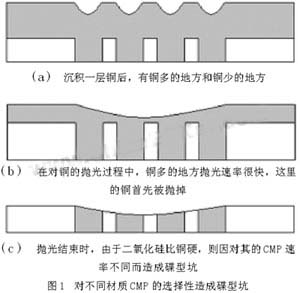
��������Ta����ʵغ�Ӳ��Ҫ����ͭ���������赲������⣬�ͱ���ѡ�ö�Ta��CMP�����ʸ߶���Cu�������ʵ͵���Һ��ʹ��ﵽ CMP����Ta:Cu = 1:1��SiO2:Cu = 1:1����ɲ��ߵ�ȫ��ƽ������
�����ڴ˹����У��漰���������⣺ͭ�����ѡ���Ժ�ͭ����ʵ�ѡ���ԡ����Ƕ��Խ�����Ҫ��ͨ�����ѧ�������������CMP���ʺܲ����ס�����ͨ���ڳ����ϵĻ����Ͻ��ͻ�ѧ���ú����е���ã�������ͭ��CMP���ʺ�������CMP���ʡ�ͭ�Ķ�㲼�ߵĽ���Ŀǰʹ�õĻ��Ƕ������裬��ˣ������Ĺ�����ͨ�����е���úͽ��Ͷ�ͭ�Ļ�ѧ������ƽ��ͭ����������CMP����Ҳ�ǿ��еġ�
�����Խ��ϵĵ���˼·�ǣ�������ϼ��ĺ��������ĥ�ϵĺ�������������֤������˼·���У������ﵽCMP����Ta:Cu = 1:1��SiO2:Cu = 1:1�����ס�����ϡ���������С��������Ũ�ȡ��Ļ���ģ�ʹﵽ�����ˡ������ʡ���ѡ��ƽ�����߽ྻ������"��е���ͻ�ѧ"����ģ�ʹﵽ���յ�ȫ��ƽ�滯���������ͻ���ʵ����Cu���� CMP�����ʡ����ʵ�ѡ���ԡ������˺�ƽ����
��������ʵ������
��������һ��ѹ��19.25��104Pa���¶�25�棻���ϵ�����450ml/min��ʹ����ҺCMPʱ��1min��ˮ��1min��
����ȡ1kg���ܽ��������м���1kgȥ����ˮ���������м���10ml���ϼ���10ml���Լ���������ȡ�ʵ�������1��ʾ��
����

�������������������Կ��������Ͷ�ͭ��������ã����е���ã�ͨ�����ĥ�ϵĺ������������Խ���ͭ��CMP���ʡ�ͬʱ�����CMP���ʽϸߣ���������������Ҫ��Ϊ�˴ﵽͭ�s�����1�s1��Ҫ����Ҫ�ټ���������ϼ��������ͭ��CMP���ʡ�
����ʵ�����ѹ��19.25��104Pa���¶�25�棻���ϵ�����450ml/min��ʹ����ҺCMPʱ��1min��ˮ��30s��
����ȡ1kg���ܽ��������м���25ml�л����������������ȣ��������м���10ml���ϼ���10ml���Լ���������ȡ�ʵ�������2��ʾ��
����

�������������������Կ�����ͭ������������������Ϊ1000nm/min���Դ����ĵ����裬������Ҳ����Ϊ�����CMP���ʣ��������ʴ�С������ͭ��CMP����һ�¡���ˣ�������Һ�ʺ�ULSI��㲼�߽����赲���CMP��
����1�� pHֵ���л���
����pHֵ���ڼ���CMP���ϵ���Ҫ��ɲ��֡�����������pHֵ�����Ӷ����ӣ�����pHֵ��ߵ�12.5�������ʽ����½�����Ϊ��Ƭ��������ˮ���������ˮ����Ϊ��ʵ�ָߵ������ʱ��뱣֤�⽬�����ȶ���pHֵ��ͨ����ΪpHֵ��9��11 ��Ϊ���롣��ѡ��һ�ֶ��Ƕష��ΪpHֵ���ڼ����Դﵽ��Ϊ�����Ч����
�������赲���CMP������ʹ��������������©�磬�������������ӵ���������Ⱦ���������һ������pHֵ���ȶ������л������������ܹ��Խ���������������ã���Чȥ���������ӡ�
����2�� �¶�
����ʵ��֤����CMP���ϵĵĻ�ѧ��Ӧ�ٶ������¶����߶����ߡ���Ƭ�������ʺ��¶ȳ����ȣ���������¶ȹ��ߣ���ѧ��Ӧ���һ�����������о����֣�CMP������¶���20��30�档
����3��ĥ��Ũ�Ⱥ�����
����ʵ�����������������SiO2 Ũ�ȵ����Ӷ���ߡ����SiO2Ũ�ȹ��ͣ���ʹ�����������õ��Ż���������Ҳ������ߡ����SiO2̫�ߣ��⽬�ϵ�ճ�Ȼ����ӣ���������ԲSiO2�����Ũ����1%��2%������ĥ�ϵ�������ͨ����Ϊĥ������ԽС��������Խ�ͣ�ĥ����������ᵼ�±��滮�ˡ�����ѡ�õ�ĥ��������Ϊ15��20nm��SiO2 ���壨�������ձ���õ�ĥ������Ϊ50��70nm����ͨ�����ѧ���ú��������ݵİ취��Ӧ��С������ĥ��Ҳ����Ч�����������ֲڶȣ���С���˲��ȣ�������Ȼ�ܹ��ﵽ�ϸߵ������ʣ�����200nm/min�����������轺��ĥ�ϵ�TEM��Ƭ��ͼ2��ʾ��
����

����4���⽬�ϵ�����
�����о��������⽬�ϵ�����ֱ��Ӱ��������ʺ�Ч�����������̫�ͣ�Ħ�������ӣ����������¶Ȳ����ȣ�ƽ�����̶Ȳ��������ʹ��Ӧ����Ѹ������оƬ���棬����оƬ��������Ħ���������ľֲ����£�оƬ������¶�һ���Ժ���Ч�����Եõ���֤����ˣ�������ʼ����С�����������¶�Ѹ����������ʴﵽƽ��ֵ��Ȼ������������֤�����ʺͱ������������Ŀǰ���ּ����Ѿ��ںܶλ�õ�Ӧ�á�
����5��������Լ�
�����о�������������Լ���CMP����������ʮ����Ҫ�����ã�Ӱ���⽬�ϵķ�ɢ�ԡ���ϴ��Ч�����������ӵ�մ�ۡ������з���FA/O������Լ����Լ�ǿ��Ӧ��ͷ�Ӧ����֮����������ݣ�����оƬ�����ƽ���ȣ���С���˲�ĺ�ȣ�������������������ϴ��������Լ����Խ��ͱ�������������ĥ�϶�оƬ��������ˣ��Ӷ����ͱ���ֲڶȣ�ͼ3����ͼ��1��2��3��Ϊ���˷壬������������ȥ�����ʣ�������Χȥ�����ʣ���4��5��6��7��Ϊ��������������ȥ�����ʣ������崦���ּ���ȥ��Ч����ʵ���˵����ˣ���ƽ���ı��档�����ȶ��Եĸ���ʹ�ý���������϶�䴫�������С��ʹ�û��������������ӿ췴Ӧ��������Լ��ļ��������˿����ڱ����ǿ����״̬��������ĥ�������������뿪���ײ��ϱ��棬ʹ�����һ�����С�
����

��

